光刻胶旋涂是光刻工艺中图形曝光前的关键步骤,其成膜均匀性直接影响后续曝光质量与图形精度。旋涂过程主要包括三步:首先,光刻胶由喷嘴喷涂于晶圆中心;随后,在高速旋转下,胶体沿径向铺展并向边缘堆积形成凸起结构;最后,在持续旋转过程中溶剂挥发,形成稳定胶膜。
通常情况下,旋涂成膜的光刻胶在晶圆径向上呈现“碗状”厚度分布,即中心与边缘区域较厚,中间区域相对平坦。这种厚度不均匀性会为后续曝光对焦带来困难。其中,中心区域厚度略高通常影响较小,而边缘堆积的胶厚可达正常区域的数倍,甚至可能流淌至晶圆背面,造成污染。
晶圆边缘与背面的多余光刻胶不仅会污染涂胶显影设备,还可能影响曝光机台乃至周边工艺区域。因此,必须在涂胶后引入专门的边缘清洗工艺,即边缘胶线去除(Edge Bead Removal, EBR),以清除多余胶体,保证后续工艺洁净度与稳定性。

图光刻胶旋涂后在晶圆边缘堆积的情况
1)溶剂反溅
在EBR工艺中,溶剂反溅是常见工艺异常。其典型特征是溶剂在清洗时溅出预定范围,可通过光学显微镜清晰观测(见图5)。反溅位置与晶圆尺寸及边缘形貌相关:在8英寸(200 mm)和12英寸(300 mm)晶圆上,反溅多集中于晶圆缺口区域,因溶剂流经缺口时易二次接触晶圆表面;而在6英寸(150 mm)带平边的晶圆上,反溅常出现在平边与圆弧边的过渡区域。此外,若EBR喷嘴出液不稳或回吸异常,也可能导致圆周其他位置发生反溅。
若反溅进入晶圆有效区域(严重时可深入数十毫米),将溶解该处光刻胶,导致曝光后无法形成有效图形。在后续刻蚀中,这些区域失去保护,会造成刻蚀异常或缺陷增加,并可能在显影步骤中引发额外缺陷,最终影响产品良率。虽然单层光刻的良率损失通常低于1%,但多层工艺累积的损失仍不可忽视。
溶剂反溅主要与硬件配置及工艺参数相关,需系统性调整与验证:
硬件优化:需结合清洗效果与反溅控制,通过重复性验证确定工艺窗口较宽的硬件设置。
运动参数优化:EBR喷嘴的移动轨迹、速度及出液/停液位置对反溅有显著影响。例如,优化喷嘴移动速度及出液起始点位置,可明显改善缺口区域的反溅情况。
喷嘴状态调试:圆周不均匀反溅通常与喷嘴出液稳定性及回吸效果有关。工艺前需确保出液平稳、无滴液异常。
喷嘴角度调整:通过调整EBR喷嘴相对于晶圆的角度,可进一步优化清洗效果并抑制反溅。
综上,需通过硬件、运动控制和喷嘴状态的协同调试,在保证边缘清洗质量的同时,有效抑制溶剂反溅。

EBR 工艺中的溶剂反溅
2)洗边宽度均匀性
工艺调试中,需借助光学显微镜检测 EBR 洗边宽度。常规在晶圆圆周 360° 范围内,每间隔 90° 选取四点测试;晶圆定位槽因切边过渡特殊,需额外左右补测两点,避免局部宽度偏差。
实际生产中易出现洗边宽度偏大、偏小或均匀性超差等问题。通用制程 EBR 洗边宽度管控区间为 1~3 mm,均匀性公差 ±0.15 mm;高阶先进制程需压缩至 0.5 mm,传统 EBR 硬件与控制方案已无法满足,需升级结构与控制系统。
EBR 制程对喷嘴运动控制、药液供给稳定性要求严苛,依托硬件结构、药液流量与配方参数协同调控。核心影响因素有三点:
- 晶圆与涂胶旋转机构的同心度,偏心偏移会直接破坏洗边均匀性;
- EBR 喷嘴结构与出液状态,决定边缘蚀刻清洗效果;
随着制程节点升级,EBR 管控标准进一步提升。工厂会沿晶圆全域每 1° 采集一组数据,以 360 组测点的标准差作为量化指标,精准监控 EBR 整体洗边品质。
EBR 切边宽度量测点位示意图
3)洗边残留问题
厚胶 EBR 工艺难度较高,因厚胶光刻胶需高固含量以满足旋涂厚度要求,而高固含量会使其残留大量溶剂,胶层流动时间延长,进而影响 EBR 阶段的胶厚稳定性。EBR 时间过长时,晶圆持续旋转易导致边缘胶层局部增厚或整体膜厚偏薄。
此外,厚胶 EBR 过程中,大量 EBR 溶剂与边缘光刻胶混合,混合液会溢流至已清洗区域,形成 “溪流” 状残留。该残留经热板烘烤后固化,即便经过晶圆边缘曝光(WEE)和显影工艺,也难以有效去除,进而引发后续刻蚀异常、晶圆缺陷,影响产品良率。
与薄胶 EBR 不同,薄胶因固含量低、溶剂挥发快、成膜迅速,EBR 时胶液与溶剂混合量少,基本无边缘残留问题。厚胶 EBR 需采用特殊工艺:可延后洗边,经预等待或预烘烤加速溶剂挥发后再执行;或选用酮类、酯类等专用溶剂(可复配使用)。溶剂选型需兼顾清洗效果、速度、成本及安全性,优先选用高挥发性且闪点合规的类型。目前,开发高效、短时、低成本且安全的厚胶 EBR 工艺,是该领域的核心研究方向。
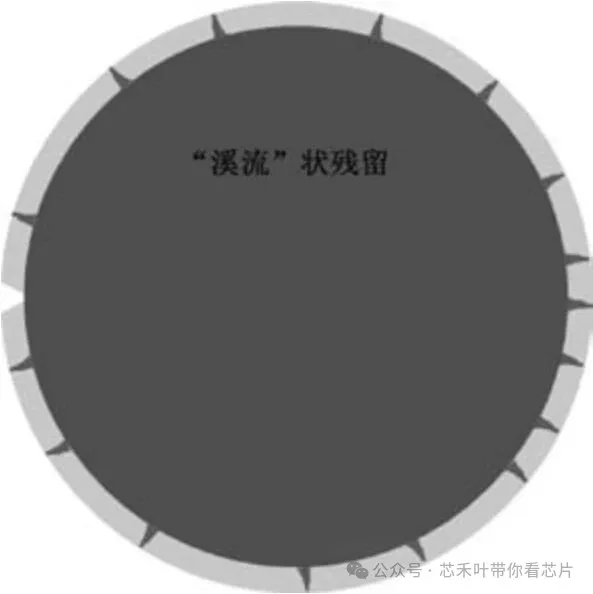
EBR 工艺过程中溶剂回流导致的“溪流”状残留
随着工艺技术节点的不断提升,对芯片加工过程有效区的控制也越来越严格,在一些先进工艺当中对EBR 的洗边宽度要求0.5 mm,均匀性±0.25 mm。 对于EBR 工艺,随着洗边宽度的减小,均匀性的控制也越来越难,传统硬件结构的EBR 喷嘴已不再适用0.7 mm 以下的宽度,新结构的EBR 必须设计新的硬件结构和喷嘴,对晶圆在涂胶单元中的送片对中精度也需要进一步提升。 同时,新结构的EBR 也需要满足不同特性晶圆的要求,具有足够的硬件兼容性。 对于翘曲度较大的晶圆也应该有足够的工艺窗口,无论是“碗型”还是“伞型”的翘曲晶圆都应该具有满足工艺指标的结果。
在一些特殊的设备配置中,EBR 需要处理不同性质的光刻胶,这时EBR 进行边缘清洗时往往需要不同性质的溶剂。 因此,在先进的设备中也可以配置多个EBR 喷嘴进行不同化学溶剂喷出达到边缘清洗的目的。 但是,在硬件结构设计时需考虑不同化学液的性质、供液管路和晶圆防溅杯的耐腐蚀性、颗粒的控制以及多个EBR 喷嘴之间是否存在运动干涉等情况。